|
品名
|
倒装焊机
|
|
型号
|
FC150 (SN200905080)
|
|
制造商
|
|
|
所属单位
|
苏州纳米技术与纳米仿生研究所(封装 加工平台)
|
|
主要功能
|
倒装焊是在裸片电极上形成连接用凸点,将芯片电极面朝下经钎焊、热压等工艺将凸点和封装基板互连的方法。由于凸点芯片倒装焊的芯片焊盘可采用阵列排布,因而芯片安装密度高,适用于高I/O数的LSI, VLSI芯片使用;倒装焊接采用芯片与基板直接安装的互连方法,具有更优越的高频、低延迟、低串扰的电路特性,更适用于高频、高速的电子产品应用。
|
|
技术指标
|
1)±3μm,3σ键合后精度;2)芯片键合,倒装键合,Wafer-wafer键合;3)100kg最大键合压力;4)最高温度:450℃ (工艺参数范围:样品尺寸5mm*5mm-5cm*5cm;样品厚度Chip小于2mm,substrate小于6mm;压力0-100kg;温度:室温-450℃)
|
|
设备现状
|
正常
|
|
收费标准
|
750/30分钟
|
|
管理员
|
严辛彦
|
|
联系方式
|
|
|
设备照片
|
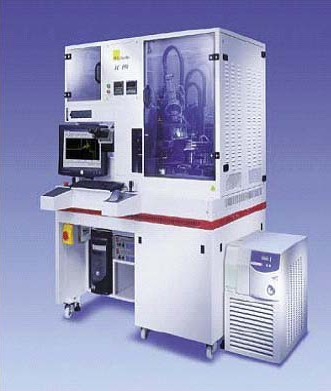
|
